
等离子刻蚀机
等离子刻蚀机,又叫等离子蚀刻机、等离子平面刻蚀机、电浆刻蚀机、等离子表面处理仪、等离子清洗系统等。等离子刻蚀,是乾法刻蚀中最常见的一种形式,其原理是暴露在电子区域的气体形成电浆,由此产生的电离气体和释放高能电子组成的气体,从而形成了等离子或离子,电离气体原子通过电场加速时,会释放足够的力量与表面驱逐力紧紧粘合材料或蚀刻表面。某种程度来讲,等离子清洗实质上是电浆刻蚀的一种较轻微的情况。进行乾式蚀刻工艺的设备包括反应室、电源、真空部分。工件送入被真空泵抽空的反应室。气体被导入并与电浆进行交换。电浆在工件表面发生反应,反应的挥发性副产物被真空泵抽走。电浆刻蚀工艺实际上便是一种反应性等离子工艺。近期的发展是在反应室的内部安装成搁架形式,这种设计的是富有弹性的,用户可以移去架子来配置合适的电浆的蚀刻方法:反应性电浆(RIE),顺流电浆(downstream),直接电浆(direction plasma)。
基本介绍
- 中文名:等离子刻蚀机
- 外文名:Plasma etching machine
- 别名:离子蚀刻机、等离子平面刻蚀机
- 最新型号:RIE反应离子刻蚀机-FA2000
- 新品功能:FA2000主要用于微电子、光电子
- 蚀刻方法:反应性电浆,顺流电浆
- 工艺频率:30 kHz和13.56 MHz射频电源
- 重量:约45公斤
产品介绍
原理
感应耦合电浆刻蚀法(Inductively Coupled Plasma Etch,简称ICPE)是化学过程和物理过程共同作用的结果。它的基本原理是在真空低气压下,ICP 射频电源产生的射频输出到环形耦合线圈,以一定比例的混合刻蚀气体经耦合辉光放电,产生高密度的电浆,在下电极的RF 射频作用下,这些电浆对基片表面进行轰击,基片图形区域的半导体材料的化学键被打断,与刻蚀气体生成挥发性物质,以气体形式脱离基片,从真空管路被抽走。
结构
ICP 设备主要包括预真空室、刻蚀腔、供气系统和真空系统四部分。
(1)预真空室
预真空室的作用是确保刻蚀腔内维持在设定的真空度,不受外界环境(如:粉尘、水汽)的影响,将危险性气体与洁净厂房隔离开来。它由盖板、机械手、传动机构、隔离门等组成。
(2)刻蚀腔体
刻蚀腔体是ICP 刻蚀设备的核心结构,它对刻蚀速率、刻蚀的垂直度以及粗糙度都有直接的影响。刻蚀腔的主要组成有:上电极、ICP 射频单元、RF 射频单元、下电极系统、控温系统等组成。
(3)供气系统
供气系统是向刻蚀腔体输送各种刻蚀气体,通过压力控制器(PC)和质量流量控制器(MFC)精準的控制气体的流速和流量。气体供应系统由气源瓶、气体输送管道、控制系统、混合单元等组成。
(4)真空系统
真空系统有两套,分别用于预真空室和刻蚀腔体。预真空室由机械泵单独抽真空,只有在预真空室真空度达到设定值时,才能打开隔离门,进行传送片。刻蚀腔体的真空由机械泵和分子泵共同提供,刻蚀腔体反应生成的气体也由真空系统排空。
影响因素
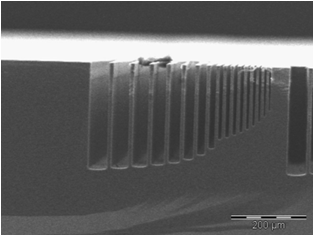 刻蚀率
刻蚀率–气压(Pressure)。
–温度(Temperature)提高温度会提高刻蚀率。
–Micro-loading
–刻蚀后腐蚀(Post-etch corrosion)。
–残留物(residual)。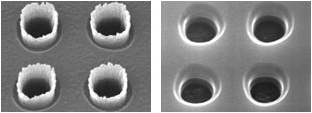 残留物
残留物
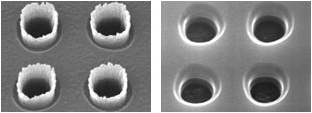 残留物
残留物缺点
1、 硅片水平运行,机片高(等离子刻蚀去PSG槽式浸泡甩乾,硅片受冲击小);
2、下料吸笔易污染硅片(等离子刻蚀去PSG后甩乾);
3、传动滚轴易变形(PVDF,PP材质且水平放置易变形);
4、成本高(化学品刻蚀代替等离子刻蚀成本增加)。
此外,有些等离子刻蚀机,如SCE等离子刻蚀机还具备“绿色”优势:无氟氯化碳和污水、操作和环境安全、排除有毒和腐蚀性的液体。SCE等离子刻蚀机支持以下四种平面电浆处理模式:
直接模式——基片可以直接放置在电极托架或是底座托架上,以获得最大的平面刻蚀效果。
定向模式——需要非等向性刻蚀(anisotropic etching)的基片可以放置在特製的平面托架上。
下游模式——基片可以放置在不带电托架上,以便取得微小的电浆效果。
定製模式——当平面刻蚀配置不过理想时,特製的电极配置可以提供。
装片
电浆系统效应的过程转换成材料的蚀刻工艺。在待刻蚀硅片的两边,分别放置一片与硅片同样大小的玻璃夹板,叠放整齐,用夹具夹紧,确保待刻蚀的硅片中间没有大的缝隙。将夹具平稳放入反应室的支架上,关好反应室的盖子。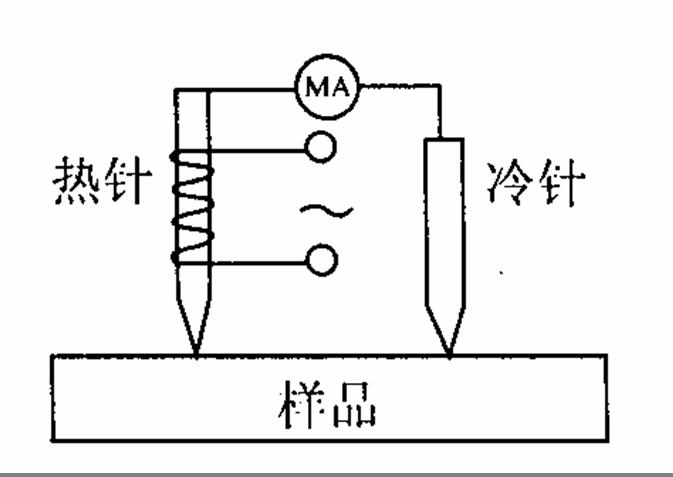 冷热探针法
冷热探针法
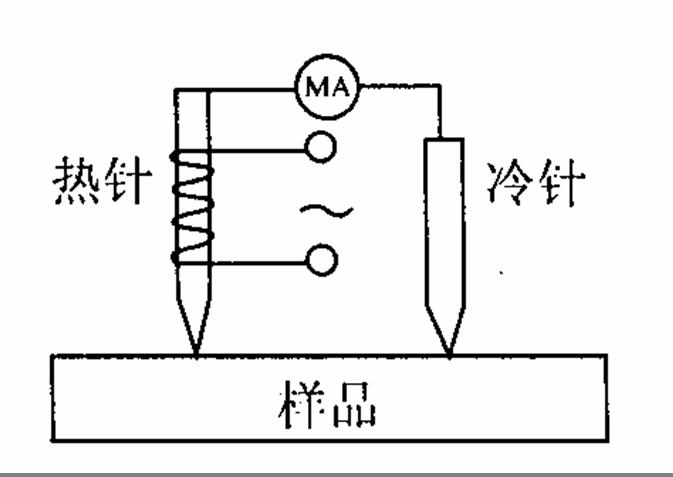 冷热探针法
冷热探针法等离子刻蚀检验原理为冷热探针法,具体方法如下:
热探针和N型半导体接触时,传导电子将流向温度较低的区域,使得热探针处电子缺少,因而其电势相对于同一材料上的室温触点而言将是正的。
同样道理,P型半导体热探针触点相对于室温触点而言将是负的。
此电势差可以用简单的微伏表测量。
热探针的结构可以是将小的热线圈绕在一个探针的周围,也可以用小型的电烙铁。
测量与控制
由于等离子刻蚀工艺中的过程变数,如刻蚀率、气压、温度、等离子阻抗,等等,不易测量,因此业界常用的测量方法有:
虚拟测量(Virtual Metrology)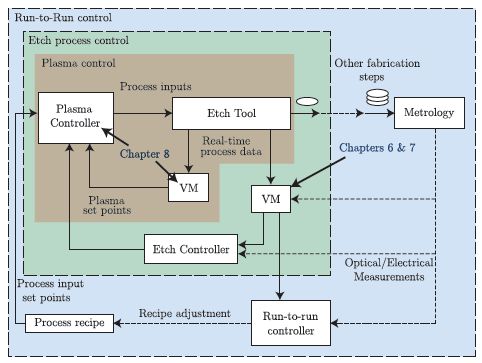 等离子刻蚀过程控制示意图
等离子刻蚀过程控制示意图
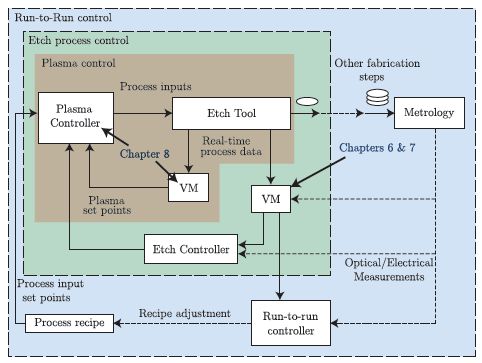 等离子刻蚀过程控制示意图
等离子刻蚀过程控制示意图光谱测量(Optical emission spectroscopy)
等离子阻抗监控(Plasma impedance monitoring)
终端探测(end-point detection)
远程耦合感测(remote-coupled sensing)
控制方法
run-to-run 控制(R2R)
模型预测控制(MPC)
人工神经网路控制
操作及判断
1. 确认万用表工作正常,量程置于200mV。
2.冷探针连线电压表的正电极,热探针与电压表的负极相连。
3.用冷、热探针接触硅片一个边沿不相连的两个点,电压表显示这两点间的电压为正值,说明导电类型为P 型,刻蚀合格。相同的方法检测另外三个边沿的导电类型是否为P型。
4.如果经过检验,任何一个边沿没有刻蚀合格,则这一批硅片需要重新装片,进行刻蚀。
检测技术
高密度电浆刻蚀是当今超大规模积体电路製造过程中的关键步骤。已经开发出许多终点检测技术,终点检测设备就是为实现刻蚀过程的实时监控而设计的。
光学发射
光学发射光谱法(OES)是使用最为广泛的终点检测手段。其原理是利用检测电浆中某种反应性化学基团或挥发性基团所发射波长的光强的变化来实现终点检测。电浆中的原子或分子被电子激发到激发态后,在返回到另一个能态时,伴随着这一过程所发射出来的光线。
光线的强度变化可从反应腔室侧壁上的观测孔进行观测。不同原子或分子所激发的光波波长各不相同,光线强度的变化反应出电浆中原子或分子浓度的变化。被检测的波长可能会有两种变化趋式:一种是在刻蚀终点时, 反应物所发出的光线强度增加;另一种情形是光线强度减弱。
雷射干涉
雷射干涉终点法(IEP)是用雷射光源检测透明薄膜厚度的变化,当厚度变化停止时,则意味着到达了刻蚀终点。其原理是当雷射垂直入射薄膜表面时,在透明薄膜前被反射的光线与穿透该薄膜后被下层材料反射的光线相互干涉。
预报式检测
随着主流半导体工艺技术由0.18 μm 逐渐转移到0.13 μm工艺,以及最新的90 nm 工艺成功研发及投入使用。半导体器件的特徵尺寸进一步减小,栅氧层的厚度越来越薄。90 nm工艺中,栅氧层的厚度仅为1.2 nm。如果电浆刻蚀工艺控制不好, 则非常容易出现栅氧层的损伤;同时, 所使用的晶片尺寸增至300mm, 暴露在电浆轰击下的被刻蚀面积不断缩小,所检测到的终点信号的强度下降,信号的信噪比降低。所有这些因素都对终点检测技术本身及其测量结果的可靠性提出了更加严格的要求。在0.18 μm工艺时,使用单一的OES检测手段就可满足工艺需求;进入0.13 μm 工艺后,就必须结合使用OES 及IEP 两种检测手段。由于IEP技术可以在刻蚀终点到达之前进行预报,因而被称为预报式终点检测技术。
套用
电浆处理可套用于所有的基材,甚至複杂的几何构形都可以进行电浆活化、电浆清洗,电浆镀膜也毫无问题。电浆处理时的热负荷及机械负荷都很低,因此,低压电浆也能处理敏感性材料。等离子刻蚀机的典型套用包括:
电浆清除浮渣
光阻材料剥离
表面处理
各向异性和各向同性失效分析套用材料改性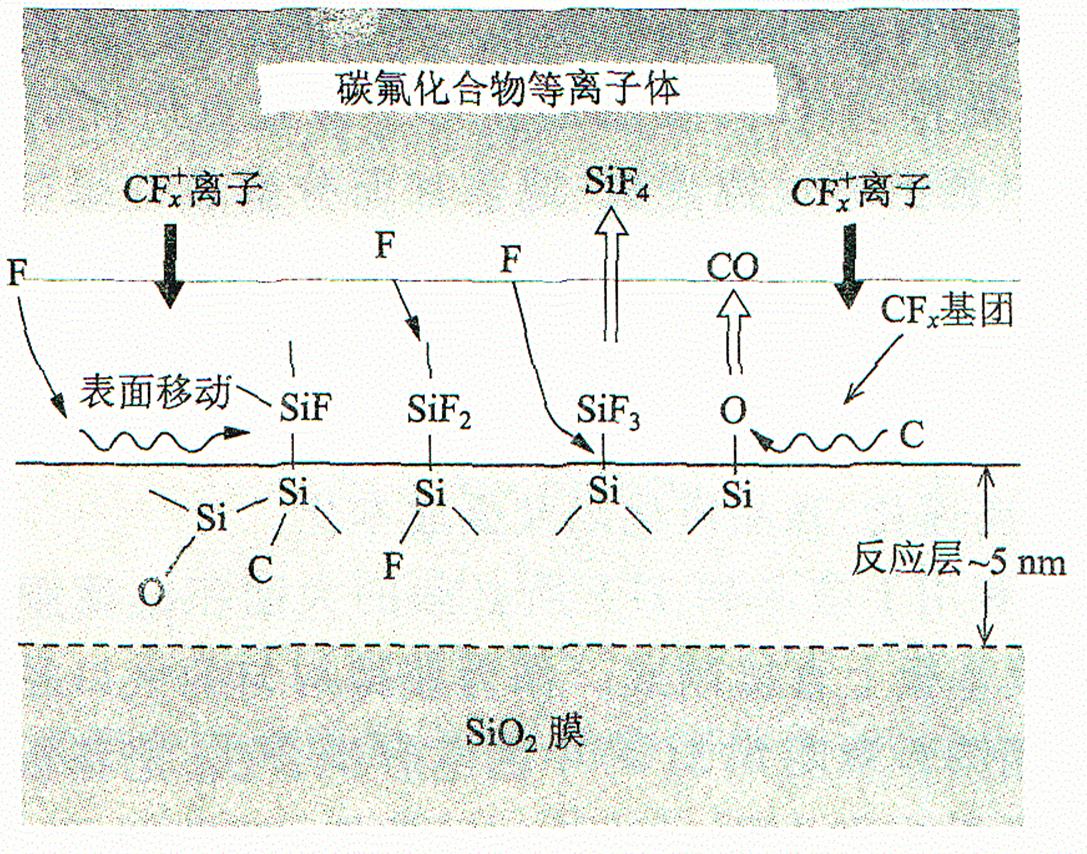 等离子刻蚀反应
等离子刻蚀反应
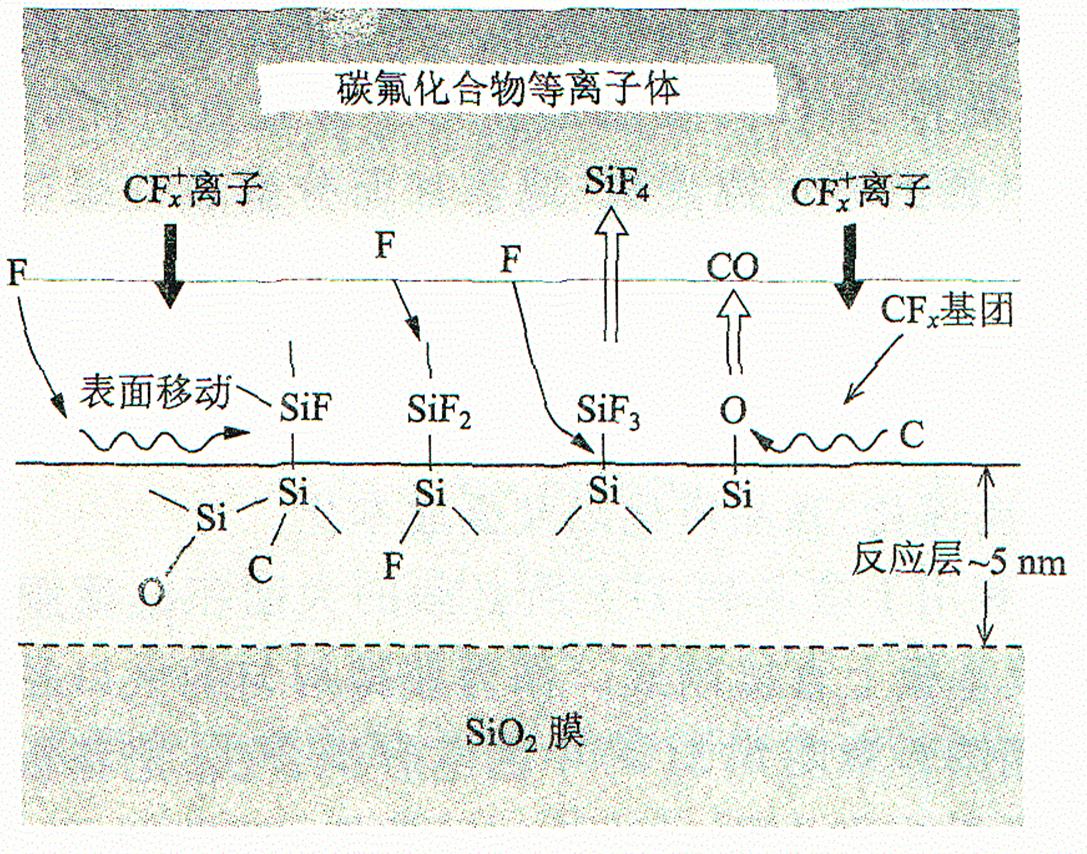 等离子刻蚀反应
等离子刻蚀反应包装清洗
钝化层蚀刻
聚亚醯胺蚀刻
增强粘接力
生物医学套用
聚合反应
混合物清洗
预结合清洗
 读书笔记摘抄新闻资讯
读书笔记摘抄新闻资讯